
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
चिप मॅन्युफॅक्चरिंगमध्ये SiGe: एक व्यावसायिक बातम्या अहवाल
सेमीकंडक्टर सामग्रीची उत्क्रांती
आधुनिक सेमीकंडक्टर तंत्रज्ञानाच्या क्षेत्रात, लघुकरणाच्या दिशेने अथक प्रयत्नाने पारंपारिक सिलिकॉन-आधारित सामग्रीच्या मर्यादा ढकलल्या आहेत. उच्च कार्यक्षमता आणि कमी उर्जा वापराच्या मागणीची पूर्तता करण्यासाठी, SiGe (सिलिकॉन जर्मेनियम) त्याच्या अद्वितीय भौतिक आणि विद्युत गुणधर्मांमुळे सेमीकंडक्टर चिप उत्पादनामध्ये पसंतीची संमिश्र सामग्री म्हणून उदयास आली आहे. हा लेख मध्ये delvesएपिटॅक्सी प्रक्रियाSiGe चे आणि एपिटॅक्सियल ग्रोथ, ताणलेले सिलिकॉन ऍप्लिकेशन्स आणि गेट-ऑल-अराऊंड (GAA) संरचनांमध्ये त्याची भूमिका.
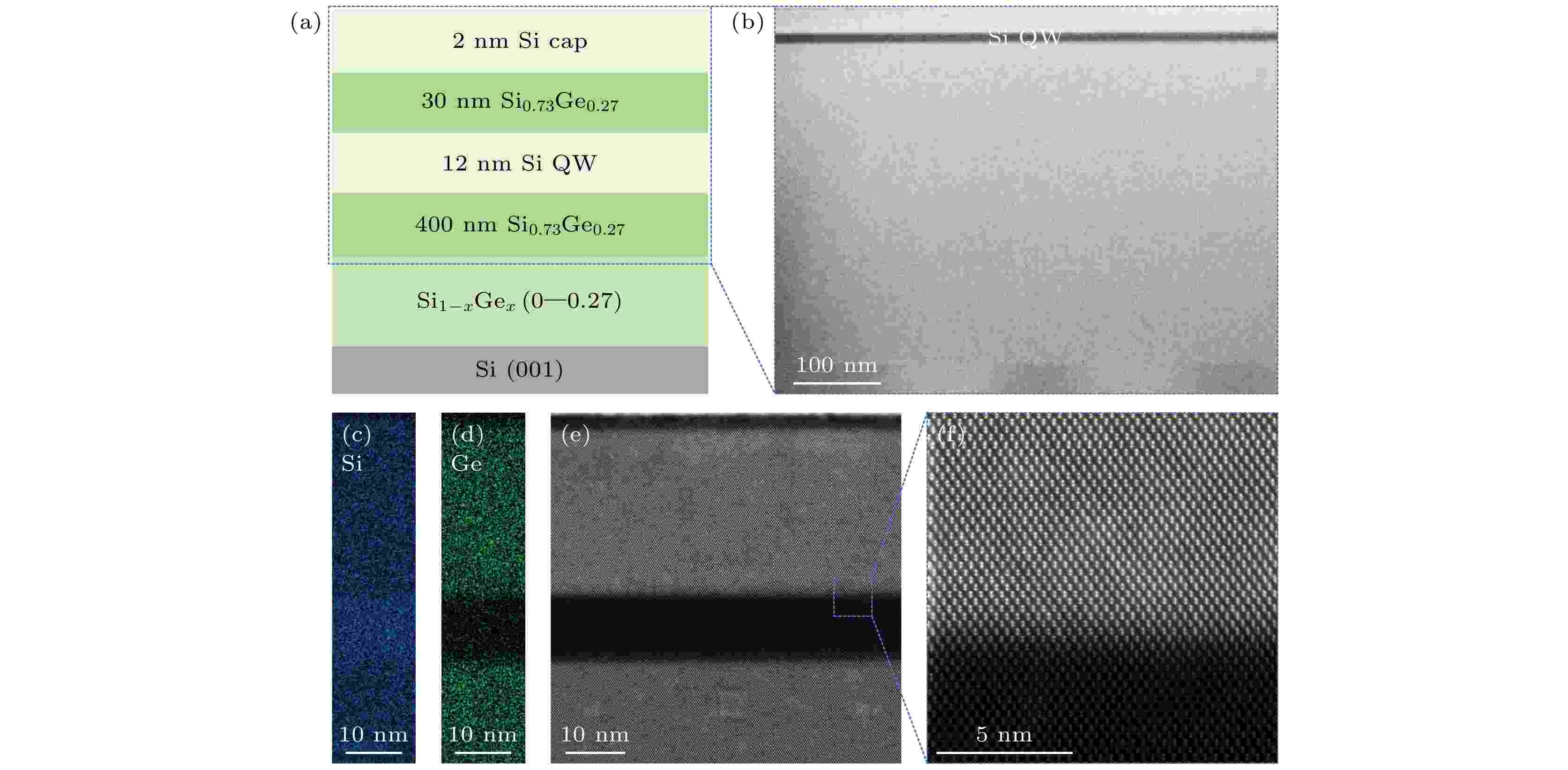
SiGe Epitaxy चे महत्त्व
1.1 चिप मॅन्युफॅक्चरिंगमधील एपिटॅक्सीचा परिचय:
Epitaxy, ज्याला बऱ्याचदा Epi असे संक्षेपित केले जाते, त्याच जाळीच्या व्यवस्थेसह सिंगल-क्रिस्टल सब्सट्रेटवर एकल-क्रिस्टल थरच्या वाढीचा संदर्भ देते. हा थर एकतर असू शकतोhomoepitaxial (जसे की Si/Si)किंवा heteroepitaxial (जसे की SiGe/Si किंवा SiC/Si). मॉलिक्युलर बीम एपिटॅक्सी (MBE), अल्ट्रा-हाय व्हॅक्यूम केमिकल वेपर डिपॉझिशन (UHV/CVD), वायुमंडलीय आणि कमी दाब एपिटॅक्सी (ATM आणि RP Epi) यासह एपिटॅक्सियल वाढीसाठी विविध पद्धती वापरल्या जातात. हा लेख सिलिकॉन (Si) आणि सिलिकॉन-जर्मेनियम (SiGe) च्या एपिटॅक्सी प्रक्रियांवर लक्ष केंद्रित करतो जे सेमीकंडक्टर इंटिग्रेटेड सर्किट उत्पादनामध्ये सिलिकॉनसह सब्सट्रेट सामग्री म्हणून मोठ्या प्रमाणावर वापरले जाते.
1.2 SiGe Epitaxy चे फायदे:
दरम्यान जर्मेनियम (Ge) चे विशिष्ट प्रमाण समाविष्ट करणेएपिटॅक्सी प्रक्रियाSiGe सिंगल-क्रिस्टल लेयर बनवते जे केवळ बँडगॅप रुंदी कमी करत नाही तर ट्रान्झिस्टरची कट-ऑफ वारंवारता (fT) देखील वाढवते. हे वायरलेस आणि ऑप्टिकल संप्रेषणांसाठी उच्च-फ्रिक्वेंसी उपकरणांमध्ये मोठ्या प्रमाणावर लागू होते. शिवाय, प्रगत CMOS इंटिग्रेटेड सर्किट प्रक्रियेत, Ge आणि Si मधील जाळी जुळत नसल्यामुळे (सुमारे 4%) जाळीचा ताण येतो, ज्यामुळे इलेक्ट्रॉन किंवा छिद्रांची गतिशीलता वाढते आणि त्यामुळे उपकरणाचा संपृक्तता प्रवाह आणि प्रतिसाद गती वाढते.
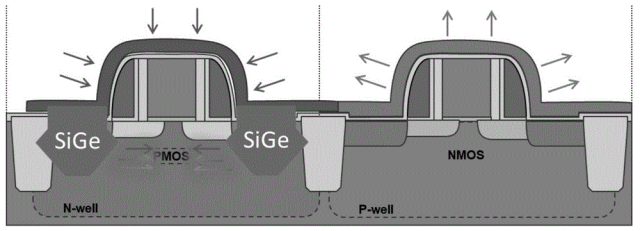
व्यापक SiGe Epitaxy प्रक्रिया प्रवाह
२.१ पूर्व-उपचार:
सिलिकॉन वेफर्सवर इच्छित प्रक्रियेच्या परिणामांवर आधारित पूर्व-उपचार केले जातात, ज्यामध्ये प्रामुख्याने नैसर्गिक ऑक्साईडचा थर आणि वेफरच्या पृष्ठभागावरील अशुद्धता काढून टाकणे समाविष्ट असते. जास्त प्रमाणात डोप केलेल्या सब्सट्रेट वेफर्ससाठी, त्यानंतरच्या काळात ऑटो-डोपिंग कमी करण्यासाठी बॅकसीलिंग आवश्यक आहे का याचा विचार करणे महत्त्वाचे आहे.एपिटॅक्सी वाढ.
2.2 वाढ वायू आणि परिस्थिती:
सिलिकॉन वायू: सिलेन (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), आणि Trichlorosilane (TCS, SiHCl₃) हे तीन सर्वात जास्त वापरले जाणारे सिलिकॉन वायू स्रोत आहेत. SiH₄ कमी-तापमान पूर्ण एपिटॅक्सी प्रक्रियेसाठी योग्य आहे, तर TCS, त्याच्या जलद वाढीच्या दरासाठी ओळखले जाते, जाड तयार करण्यासाठी मोठ्या प्रमाणावर वापरले जाते.सिलिकॉन एपिटॅक्सीस्तर
जर्मेनियम वायू: जर्मेनियम (GeH₄) हा जर्मेनियम जोडण्याचा प्राथमिक स्रोत आहे, जो SiGe मिश्रधातू तयार करण्यासाठी सिलिकॉन स्त्रोतांच्या संयोगाने वापरला जातो.
निवडक एपिटॅक्सी: च्या सापेक्ष दर समायोजित करून निवडक वाढ साध्य केली जातेएपिटॅक्सियल डिपॉझिशनआणि क्लोरीन युक्त सिलिकॉन वायू DCS वापरून सिटू एचिंगमध्ये. सिलिकॉनच्या पृष्ठभागावरील Cl अणूंचे शोषण ऑक्साइड किंवा नायट्राइड्सपेक्षा कमी असल्याने, एपिटॅक्सियल वाढ सुलभ करते. SiH₄, Cl अणूंचा अभाव आणि कमी सक्रियता उर्जेसह, सामान्यत: केवळ कमी-तापमान पूर्ण एपिटॅक्सी प्रक्रियांवर लागू होते. आणखी एक सामान्यतः वापरल्या जाणाऱ्या सिलिकॉन स्त्रोत, TCS मध्ये बाष्पाचा दाब कमी असतो आणि तो खोलीच्या तपमानावर द्रव असतो, त्याला प्रतिक्रिया कक्षेत आणण्यासाठी H₂ बबलिंगची आवश्यकता असते. तथापि, हे तुलनेने स्वस्त आहे आणि बऱ्याचदा त्याच्या जलद वाढीच्या दरासाठी (5 μm/मिनिट पर्यंत) दाट सिलिकॉन एपिटॅक्सी थर वाढण्यासाठी वापरले जाते, सिलिकॉन एपिटॅक्सी वेफर उत्पादनात मोठ्या प्रमाणावर वापरले जाते.
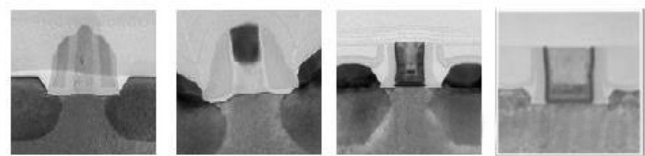
एपिटॅक्सियल लेयर्समध्ये ताणलेले सिलिकॉन
दरम्यानएपिटॅक्सियल वाढ, एपिटॅक्सियल सिंगल-क्रिस्टल Si एका आरामशीर SiGe स्तरावर जमा केले जाते. Si आणि SiGe मधील जाळीच्या विसंगतीमुळे, Si सिंगल-क्रिस्टल लेयरला अंतर्निहित SiGe लेयरमधून तणावग्रस्त ताण येतो, ज्यामुळे NMOS ट्रान्झिस्टरमधील इलेक्ट्रॉन गतिशीलता लक्षणीयरीत्या वाढते. हे तंत्रज्ञान केवळ सॅचुरेशन करंट (आयडसॅट) वाढवत नाही तर उपकरणाच्या प्रतिसादाची गती देखील सुधारते. पीएमओएस उपकरणांसाठी, चॅनेलवर संकुचित ताण आणण्यासाठी, छिद्रांची गतिशीलता वाढवण्यासाठी आणि संपृक्तता प्रवाह वाढवण्यासाठी नक्षीकामानंतर SiGe स्तर epitaxially उगवले जातात.
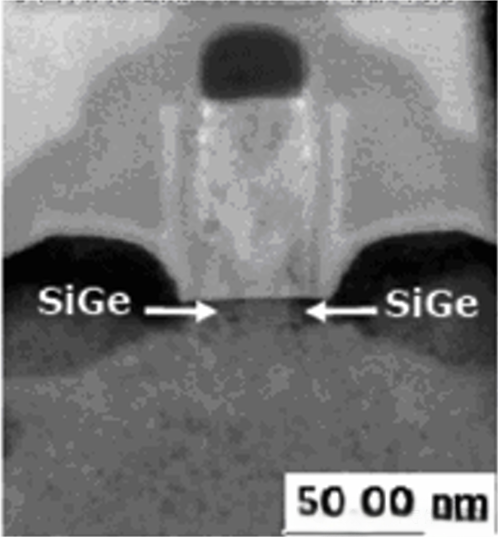
GAA स्ट्रक्चर्समध्ये एक बलिदान स्तर म्हणून SiGe
गेट-ऑल-अराउंड (GAA) नॅनोवायर ट्रान्झिस्टरच्या निर्मितीमध्ये, SiGe लेयर्स बलिदान स्तर म्हणून काम करतात. क्वासी-एटॉमिक लेयर एचिंग (क्वासी-एएलई) सारख्या उच्च-निवडक ॲनिसोट्रॉपिक एचिंग तंत्र, नॅनोवायर किंवा नॅनोशीट स्ट्रक्चर्स तयार करण्यासाठी SiGe स्तर अचूकपणे काढून टाकण्याची परवानगी देतात.
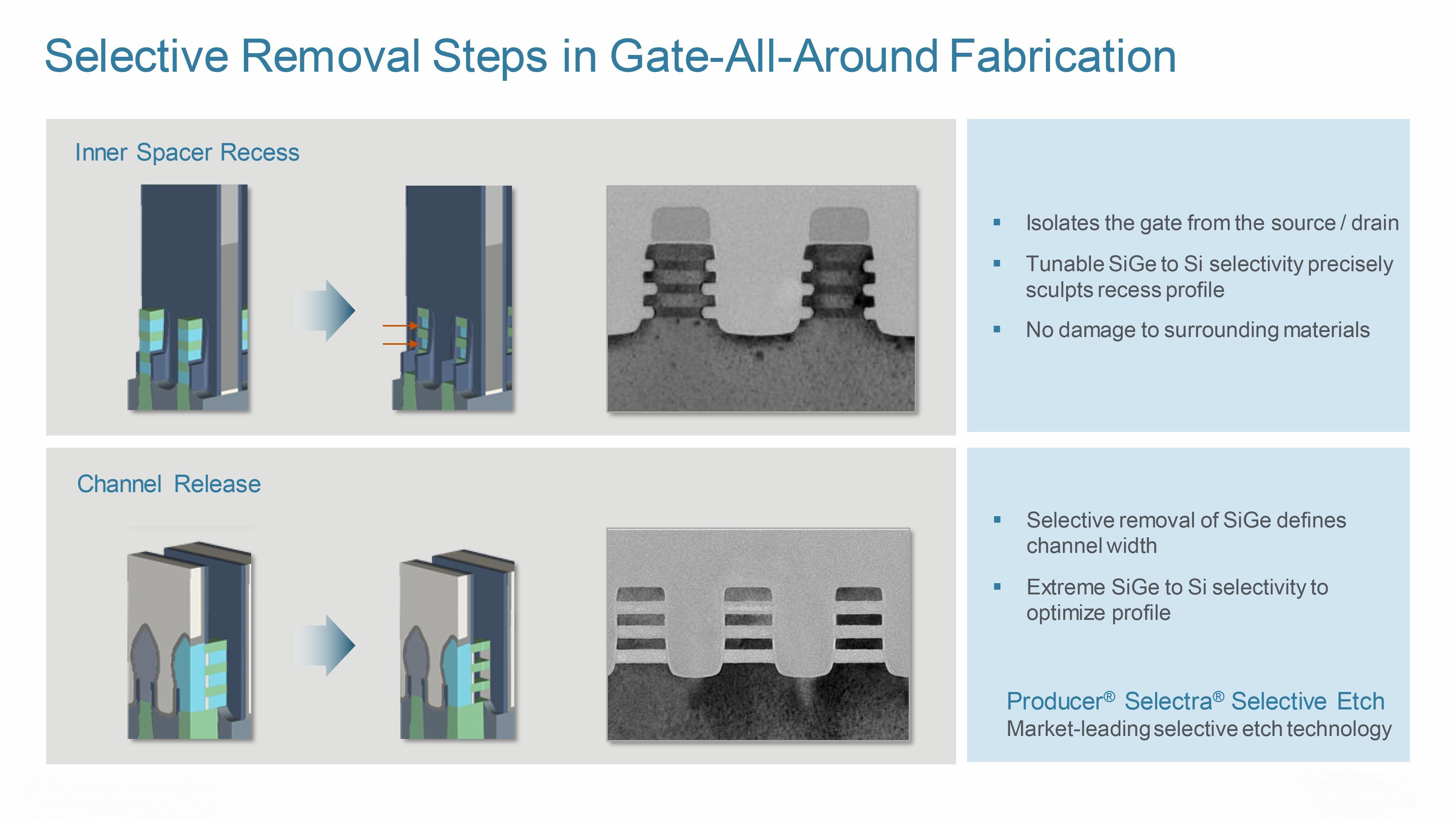
आम्ही Semicorex मध्ये विशेष आहोतSiC/TaC लेपित ग्रेफाइट सोल्यूशन्ससेमीकंडक्टर मॅन्युफॅक्चरिंगमध्ये Si epitaxial ग्रोथ मध्ये लागू, तुमच्याकडे काही चौकशी असल्यास किंवा अतिरिक्त तपशीलांची आवश्यकता असल्यास, कृपया आमच्याशी संपर्क साधण्यास अजिबात संकोच करू नका.
संपर्क फोन: +86-13567891907
ईमेल: sales@semicorex.com




