
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
LPCVD प्रक्रिया काय आहेत?
कमी दाबाच्या रासायनिक वाष्प जमा (LPCVD) प्रक्रिया ही CVD तंत्रे आहेत जी कमी दाबाच्या वातावरणात वेफर पृष्ठभागांवर पातळ फिल्म सामग्री जमा करतात. सेमीकंडक्टर उत्पादन, ऑप्टोइलेक्ट्रॉनिक्स आणि पातळ-फिल्म सोलर सेलसाठी मटेरियल डिपॉझिशन टेक्नॉलॉजीमध्ये LPCVD प्रक्रिया मोठ्या प्रमाणावर वापरल्या जातात.
LPCVD ची प्रतिक्रिया प्रक्रिया सामान्यत: 1-10 टॉरच्या दाबाने, कमी-दाब प्रतिक्रिया कक्षामध्ये केली जाते. डिपॉझिशन रिॲक्शनसाठी योग्य तापमान रेंजवर वेफर गरम केल्यानंतर, डिपॉझिशन चेंबरमध्ये वायू पूर्ववर्ती प्रवेश केला जातो. प्रतिक्रियाशील वायू वेफरच्या पृष्ठभागावर पसरतात आणि नंतर उच्च तापमानाच्या स्थितीत वेफरच्या पृष्ठभागावर रासायनिक अभिक्रिया होऊन घन साठे (पातळ फिल्म्स) तयार होतात.
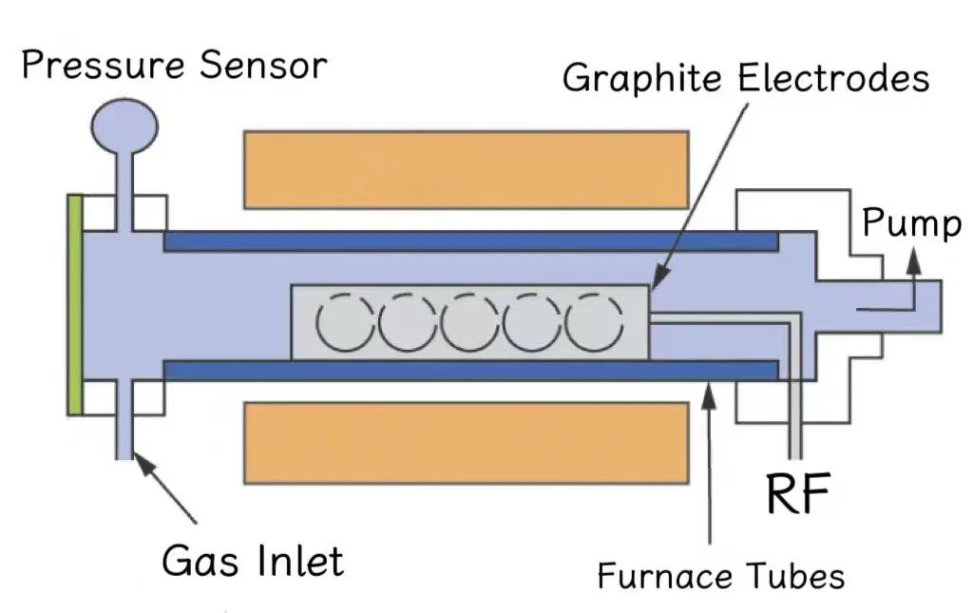
LPCVD प्रक्रियेचे फायदे
1. उच्च-गुणवत्तेची पातळ फिल्म डिपॉझिशन गुणवत्ता
जेव्हा दाब कमी असतो तेव्हा अभिक्रियाशील वायूंचा वाहतूक दर वाढतो कारण वायूंचा प्रसार गुणांक वाढतो. अशा प्रकारे, संपूर्ण प्रतिक्रिया कक्षामध्ये गॅस रेणूंचे अधिक एकसमान वितरण तयार केले जाऊ शकते, जे सुनिश्चित करते की वायू रेणू पूर्णपणे वेफर पृष्ठभागावर प्रतिक्रिया देतात आणि अपूर्ण प्रतिक्रियांमुळे व्हॉईड्स किंवा जाडीतील फरक लक्षणीयरीत्या कमी करतात.
२.उत्कृष्ट हा चित्रपट स्टेप कव्हरेज
कमी दाबाखाली वाढलेली वायू प्रसार क्षमता त्यास जटिल संरचनांमध्ये खोलवर प्रवेश करण्यास अनुमती देते. हे सुनिश्चित करते की प्रतिक्रियाशील वायू वेफरच्या पृष्ठभागावरील पायऱ्या आणि खंदकांच्या पूर्ण संपर्कात आहे, पातळ फिल्म्सचे एकसमान निक्षेप प्राप्त करते. परिणामी, एलपीसीव्हीडी पद्धतीसाठी क्लिष्ट संरचनांवर पातळ फिल्म डिपॉझिशन एक चांगला अनुप्रयोग आहे.
3. मजबूत ऑपरेशनल कंट्रोलेबिलिटी
LPCVD प्रक्रिया प्रत्यक्ष ऑपरेशन दरम्यान मजबूत नियंत्रणक्षमता प्रदर्शित करतात. प्रकार, प्रवाह दर, तापमान आणि दाब यांसारख्या अभिक्रियात्मक वायूचे मापदंड समायोजित करून पातळ फिल्मची रचना, रचना आणि जाडी अचूकपणे नियंत्रित केली जाऊ शकते. इतर डिपॉझिशन तंत्रज्ञानाच्या तुलनेत LPCVD उपकरणांमध्ये तुलनेने कमी गुंतवणूक आणि परिचालन खर्च आहे, ज्यामुळे ते मोठ्या प्रमाणावर औद्योगिक उत्पादनासाठी योग्य बनते. आणि मोठ्या प्रमाणात उत्पादनादरम्यान प्रक्रियांमधील सुसंगतता स्वयंचलित प्रणालींद्वारे प्रभावीपणे सुनिश्चित केली जाऊ शकते जी रिअल टाइममध्ये निरीक्षण आणि समायोजित करतात.
LPCVD प्रक्रियेचे तोटे
LPCVD प्रक्रिया सामान्यत: उच्च तापमानात केल्या जात असल्याने, जे काही तापमान-संवेदनशील सामग्रीच्या वापरास मर्यादित करते, LPCVD द्वारे प्रक्रिया करणे आवश्यक असलेल्या वेफर्स उष्णता-प्रतिरोधक असणे आवश्यक आहे. LPCVD प्रक्रियेदरम्यान, अवांछित समस्या उद्भवू शकतात, जसे की वेफर रॅप-अराउंड डिपॉझिशन (वेफरच्या लक्ष्य नसलेल्या भागात पातळ फिल्म्स जमा केल्या जातात) आणि इन-सिटू डोपिंगमध्ये अडचणी, ज्याचे निराकरण करण्यासाठी नंतरच्या प्रक्रियेची आवश्यकता असते. या व्यतिरिक्त, कमी दाबाच्या परिस्थितीत बाष्पाच्या पूर्ववर्ती घटकांच्या कमी एकाग्रतेमुळे पातळ फिल्म जमा होण्याचे प्रमाण कमी होऊ शकते, ज्यामुळे अकार्यक्षम उत्पादन कार्यक्षमता होऊ शकते.
Semicorex उच्च-गुणवत्तेची ऑफर करतेSiC furnace ट्यूबs, SiC cantilever paddlesआणिSiC वेफर बोटीLPCVD प्रक्रियेसाठी. आपल्याकडे काही चौकशी असल्यास किंवा अतिरिक्त तपशीलांची आवश्यकता असल्यास, कृपया आमच्याशी संपर्क साधण्यास अजिबात संकोच करू नका.
संपर्क फोन # +86-13567891907
ईमेल: sales@semicorex.com





